HDI厂:先进封装强势崛起,影响IC产业格局
摩尔定律的延伸受到物理极限、巨额资金投入等多重压力,迫切需要别开蹊径延续工艺进步。而通过先进封装集成技术,可以更轻松地实现高密度集成、体积微型化和更低的成本。封装行业将在集成电路整体系统整合中扮演更重要的角色,也将对产业的格局形成更多影响。随着先进封装的推进,集成电路产业将展现出一些新的发展趋势,有先进封装的集成电路产业样貎将会有所不同。
先进封装增速远超传统封装
就HDI厂了解,当前社会正处于新技术与新应用全面爆发的背景下,移动设备、大数据、人工智能、5G通信、高性能计算、物联网、智能汽车、智能工业等快速发展。这些技术与应用必将对底层芯片技术产生新的需求。据麦姆斯咨询的介绍,支持这些新兴大趋势的电子硬件需要高计算能力、高速度、更多带宽、低延迟、低功耗、更多功能、更多内存、系统级集成、更精密的传感器,以及最重要的低成本。这些新兴趋势将为各种封装平台创造商机,而先进封装技术是满足各种性能要求和复杂异构集成需求的理想选择。
目前来看,扇出型封装(FOWLP/)、系统级封装(SiP)、3D封装是最受关注的三种先进封装技术。扇出型封装是晶圆级封装中的一种,相对于传统封装具有不需要引线框、基板等介质的特点,因此可以实现更轻薄短小的封装。根据IC Insight预计,在未来数年之内,利用扇出型封装技术生产的芯片,每年将以32%的增长率持续扩大,2023年扇出型封装市场规模将超过55亿美元。
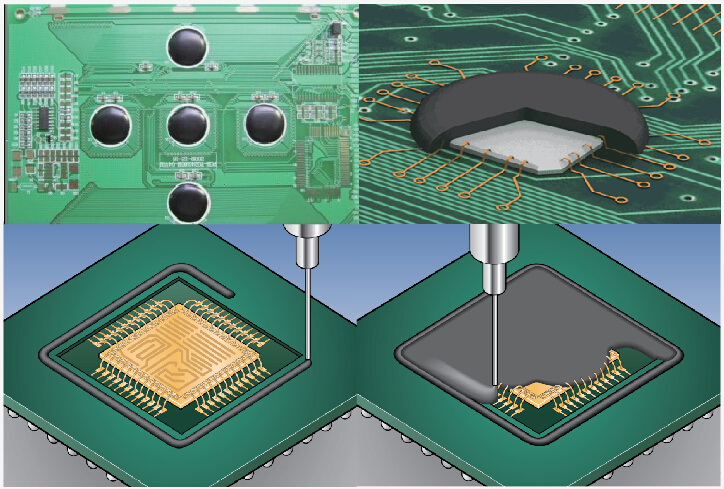
系统级封装可以将一个或多个IC芯片及被动元件整合在一个模块中,从而实现具有完整功能的电路集成,它也可以降低成本,缩短上市时间,同时克服了SoC中诸如工艺兼容、信号混合、噪声干扰、电磁干扰等难题。
3D封装通过晶圆级互连技术实现芯片间的高密度封装,可以有效满足高功能芯片超轻、超薄、高性能、低功耗及低成本的需求,被大多半导体厂商认为是最具有潜力的封装方法。
总之,在市场需求的带动下,越来越多先进封装技术被开发出来,先进封装的市场占比将会进一步扩大。HDI厂了解到,从2017年到2023年,整个半导体封装市场的营收将以5.2%的年复合增长率增长,而先进封装市场将以7%的年复合增长率增长,市场规模到2023年将增长至390亿美元,传统封装市场的复合年增长率则低于3.3%。
(1).jpg)
展现三大发展趋势
随着先进封装技术的发展以及市场规模的扩大,其对于整个集成电路产业结构将产生越来越大的影响。首先是中段工艺的出现并逐渐形成规模。随着传统封装技术向先进封装过渡,有别于传统封装技术的凸块(Bumping)、再布线(RDL)、硅通孔(TSV)等中段工艺被开发出来,并且开始发挥重要作用。中芯长电半导体首席执行官崔东表示,仅靠缩小线宽的办法已经无法同时满足性能、功耗、面积,以及信号传输速度等多方面的要求,因此半导体企业开始把注意力放在系统集成层面来寻找解决方案,也就是通过先进的硅片级封装技术,把不同工艺技术代的裸芯封装在一个硅片级的系统里,兼顾性能、功耗和传输速度的要求。这就产生了在硅片级进行芯片之间互联的需要,进而产生了凸块、再布线、硅通孔等中段工艺。而中段硅片加工的出现,也打破了前后段芯片加工的传统分工方式。
其次,制造与封装将形成新的竞合关系。由于先进封装带来的中段工艺,封测业和晶圆制造业有了更紧密的联系,在带来发展机遇的同时,也面临着新的挑战。中段封装的崛起必然挤压晶圆制造或者封装测试业的份额。有迹象表明,部分晶圆厂已加大在中段封装工艺上的布局。晶圆厂有着技术和资本的领先优势,将对封测厂形成较大的竞争压力。传统封测厂较晶圆制造业相比属于轻资产,引入中段工艺后,设备资产比重较传统封装大大增加,封测业的先进技术研发和扩产将面临较大的资金压力。
最后,推动集成电路整体实力的提升。后摩尔时代的集成电路产业更强调产业链的紧密合作,强化产业链上下游之间的内在联系,要求各个环节不再是割裂地单独进行生产加工,而是要求从系统设计、产品设计、前段工艺技术和封测各个环节开展更加紧密的合作。企业对于先进封装业务的竞争,最终还需表现为产业链之间综合实力的竞争。

中国应加快虚拟IDM生态链建设
近几年中国集成电路封测产业实现了高速发展,有了长足的进步,然而国内集成电路封测产业链整体技术水平不高也是不争的事实。半导体专家莫大康认为,中国现在非常重视集成电路产业,推动先进封装业的发展就是非常必要的了。中国的封装测试是集成电路三业(设计、制造、封测)中起步最早的,与国际水平差距也比较小,因此完全有能力发展起来。
华进半导体总经理曹立强在近日的演讲中再次提出,推动国内“EDA软件—芯片设计—芯片制造—芯片封测—整机应用”集成电路产业链虚拟IDM生态链的建设,以市场需求牵引我国集成电路封测产业快速发展。集成电路的竞争最终会表现为产业链之间综合实力的竞争,先进封装的发展需要从工艺、设备和材料等方面的协同。
在新的技术趋势和竞争环境下,集成电路产业越来越表现为产业链整体实力的竞争。过去几年,国际半导体制造公司纷纷加大力度向先进工艺挺进,在持续大规模资本投入扩建产能的带动下,一些半导体制造大厂同样具备了完整的先进封装制造能力。
ps:部分图片来源于网络,如有侵权,请联系我们删除
最新产品
触摸屏HDI
服务智能机器人线路板
-

-
型号:M04C16614
层数:4层
板材:GW1500
板厚:1.6+/-0.16mm
尺寸:124mm*114mm
最小孔径:0.2mm
最小线宽:0.094mm
最小线距:0.107mm
过孔距PAD≤0.1mm
表面处理:沉金
服务智能机器人线路板
-

-
型号:M04C23782
层数:4层
板材:GW1500
板厚:1.6+/-0.16mm
尺寸:124mm*118mm
最小孔径:0.25mm
最小线宽:0.112mm
最小线距:0.102mm
表面处理:沉金
最小BGA:0.6mm
过孔距PAD:0.1mm
家庭智能机器人线路板
-

-
型号:M04C33188
层数:4层
板厚:1.2+/-0.12mm
尺寸:121.96mm*132.05mm
最小孔径:0.25mm
最小线宽:0.116mm
最小线距:0.168mm
表面处理:沉金
最小绿油桥:0.08mm
过孔距PAD≤0.1mm
智能Wifi线路板
-
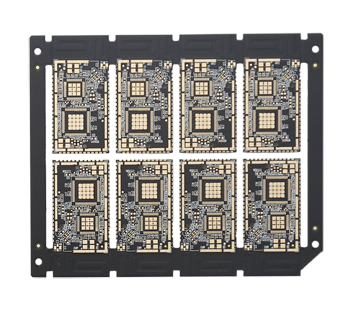
-
型号:TM04C02677
层数:4层
板材:EM825
板厚:1.0mm
尺寸:92mm*76mm/8
最小孔径:0.20mm
最小线宽:0.1mm
最小线距:0.127mm
表面处理:沉金2u"-10u"
油墨颜色:哑光黑油
特殊难点:阻抗+半孔,阻焊单面开窗设计
家庭智能机器人线路板
智能家居温控器线路板
-

-
型号:M02C22186
层数:2层
板厚:1.6mm
尺寸:293.37mm*203.2mm
所用板材:FR4+PI+NFPP
最小孔径:0.4mm
最小线宽:0.305mm
最小线距:0.406mm
表面处理:沉金
结构方式:上下非对称结构
智能手环线路板
同类文章排行
- IC载板发展历程,类载板有望取代HDI引领新一轮变革
- PCB之华为P30系列供应商名单全曝光!
- 电池电路板厂之手机电池的那些“误会”
- 电池电路板厂之从1G到5G手机进化史,鬼知道手机经历了什么?
- 电路板厂为您解析PCB拼板设计
- 【电路精选】线路板厂为你解析汽车防盗系统中的模块电路设计
- 导入采用IC基板的类基板手机HDI技术
- 2014中国线路板厂排名,你知道几家?
- 新能源汽车特有核心单元,带动电池线路板厂新增长
- 盲埋孔电路板的规格
最新资讯文章
- 探秘盲埋孔线路板厂:如何用精密工艺打造电路 “隐形脉络”?
- 探寻电池电路板厂的前沿洞察:行业发展驶向何方?
- 探秘盲埋孔线路板厂:怎样解锁精密制造的密码?
- 5G时代给PCB厂带来哪些新挑战?
- 智能化浪潮中,电路板厂怎样推进智能制造升级?
- 智能化浪潮下,汽车车灯线路怎样实现精准控制与智能交互?
- 智能化转型,电池电路板厂如何破局?
- 手机摄像头线路板的未来发展方向在哪?
- 线路板厂:智能制造的未来之路
- PCB厂分享:我国新型PCB产业分析








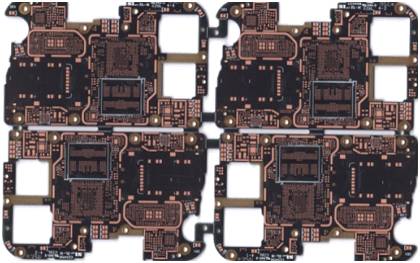








共-条评论【我要评论】