塞孔一词对印刷电路板业界而言并非是新名词,早期在外层线路的蚀刻制程时为避免Dry-Film Tenting 在PTH 孔Ring 边过小,无法完全盖孔造成孔壁电镀层遭蚀刻而成Open的不良出现,当时曾采塞孔法填入暂时性油墨以保护孔壁,后因Tin Tenting制程在市场上成为主流此工法才逐渐被淘汰;即便如此现行多层板亦被要求防焊绿漆塞孔;但上述制程皆为应用于外层之塞孔作业,本文所要探讨的主题是以内层埋孔塞孔技术为主。
关键词:Stack Via,CTE,Aspect Ratio,网印印刷塞孔,滚轮刮印填孔
一 前言
HDI板高密度连接技术的时代,线宽与线距等将无可避免往愈小愈密的趋势发展,也因而衍生出不同以往型态的PCB结构出现,如Via on Pad、Stack Via 等等,在此前提下内层埋孔通常被要求完全填满并研磨平整以增加外层的布线面积,市场的需求不仅考验PCB业者的制程能力同时也迫使原物料供货商必须开发出更Hi-Tg、Low CTE、低吸水率、无溶剂、低收缩率、容易研磨等等特性的塞孔油墨以满足业界的需求。塞孔段之主要流程为钻孔、电镀、孔壁粗化(塞孔前处理)、塞孔、烘烤、研磨等。在此将针对树脂塞孔制程做较为详尽的介绍。
二 HDI板内层塞孔目的
除上述布线面积为主要的考虑外尚有介质层均一厚度之要求,内层塞孔目的为:
1. 避免外层线路讯号的受损。
2. 做为上层迭孔结构的基地。
3. 符合客户特性阻抗的要求。
三 现行内层塞孔方式与能力
常见的内层塞孔方式有增层压合填孔(可分为RCC 及HR 高含胶量PP 等,本文所举皆以RCC 压合填孔为例)与树脂油墨塞孔等两种,一般而言内层若为小孔径,低纵横比及孔数少之埋孔可使用增层压合自然填充方式塞孔;而大孔径、高纵横比与孔数多之埋孔,则将因RCC 之含胶量不足以填充较大与较深孔径之埋孔,因此不适合以此种方式塞孔,含胶量若无法完全填充埋孔将造成塞孔气泡、凹陷与介质厚度不足等等问题的出现,此亦将影响产品整体之可靠度。RCC 所含之树脂(胶)也同时拥有相对较高之热膨胀系数CTE ( Coefficient of Thermal Expansion),此为典型RCC 所内含树脂的特性,过高的CTE 将促使填充材料在受热 (如冷热冲击、热应力等信赖性测试) 的过程中发生龟裂(Crack)或分层(Delamination)的情形;两种材料之间存在差异甚大的CTE 与内含塞孔气泡均为导致上述不良的主要原因。
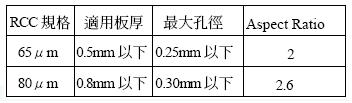
表一. RCC 填孔能力(适用板厚较薄、孔数较少之内层)
内层塞孔通常要求需100%塞满,如图一所示当出现纵横比较大的孔径时,无论何种增层压合填孔方式都将无法满足此项要求,此时仅能选择以树脂油墨塞孔来进行塞孔作业。

图一. 树脂油墨塞孔(纵横比4.6)
为达内层塞孔100%塞满之需求,塞孔操作压力无可避免的将造成孔径之两端油墨额外突出,因此塞孔油墨在硬化后尚需将两端突出之油墨予以研磨平整,方可进行下一工序,避免在后续的金属化或线路制程中形成电镀不良与线路断路等等不良后果的出现。树脂油墨塞孔又可区分为:
1. 网印印刷塞孔。
2. 滚轮刮印填孔。

表二. 树脂油墨塞孔能力(以网印印刷塞孔为例,适用板厚与纵横比)

 触摸屏HDI
触摸屏HDI 服务智能机器人线路板
服务智能机器人线路板 服务智能机器人线路板
服务智能机器人线路板 家庭智能机器人线路板
家庭智能机器人线路板