在多年的电路板(盲埋孔线路板)技术发展中,如何作出更小的孔及更细的线路一直是电路板业界努力的目标。从早期的每一通道几条线的讨论议题,转变为现在的线宽间距几条(mil)。而对某些特定的产品,甚至是以公制的微米为讨论的标的。以往所谓的“2line or line per channel”,对现代的产品而言,已成为一种较粗糙的描述,较精准的语言已改为线宽间距的尺寸描述。
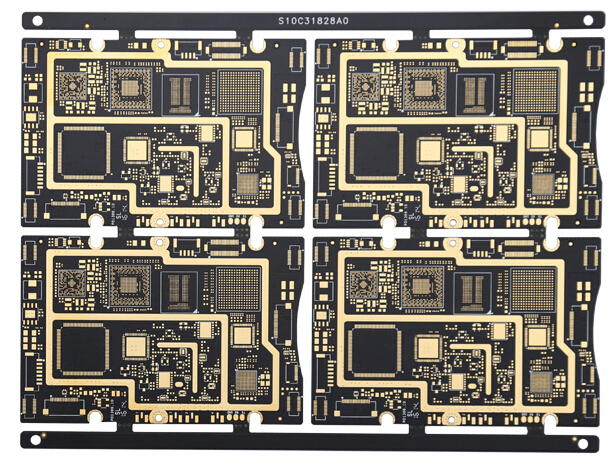
一般的高密度电路板(盲埋孔线路板)主要是因应阵列式的构装结构需求,而提升线路与焊垫的密度,目前较大的BGA构装球间距仍然保持在1.0-0.25mm左右的距离。因此多数的电路板只要符合这样的组装要求,应该就可以达成电路板的任务,因此多数的制作规格都停留在3-5mil之间,但是对构装载板方面的高密度应用,因为必须面对晶片的接点密度,因此25;30;40;50um的产品规格已经十分常见。而对于如:COF(chip on flex)及特殊的半导体构装板而言,20um或更细的线路也被涵盖在讨论之列。因此,如何成功的制作高阶盲埋孔线路板产品,细线路的制作就成为关键的课题。
基本上电路板与多数的构装载板线路制作,主要还是采用铜金属为基础。因此,很难以半导体的技术利用电浆蚀刻制作线路。加上一般基板所制作的线路厚度,多数都是10um以上的规格较为常见,即使是软质电路板制作细密的线路,铜厚度要求也都保持在约5-7um以上,这就考验着线路制作的技术能力了。

 触摸屏HDI
触摸屏HDI 服务智能机器人线路板
服务智能机器人线路板 服务智能机器人线路板
服务智能机器人线路板 家庭智能机器人线路板
家庭智能机器人线路板