随着目前电子产品持续而迅速小型化、轻便化、多功能化的趋势,高密度的安装技术的发展,行业上对于作为原件载体和连接体的印制电路提出了更高的要求,以便其能够成为具有高密度、高精度、高可靠性并且能大幅度提高组装密度的电子元部件。因此应用于新的PCB工艺技术的高密度互连HDI被广泛应用于各种电子产品。
HDI叠孔技术作为HDI制作过程中比较高端的一种工艺技术,不仅可以实现线路板内部层次间的选择性互联,充分提高了线路板的布线密度以及空间利用率。
HDI板盲孔叠孔制作过程中所采用的电镀填孔工艺,可有效的提高线路板的焊接面积,消除虚焊的隐患,减少焊盘中盲孔焊接气泡的产生,增强了焊接的可靠性,同时,填孔后线路板表面平整,有利于密集线路的制作,叠孔形成的铜柱提高了线路板的散热功能。
二、叠孔分类
① 一阶HDI板(无埋孔)
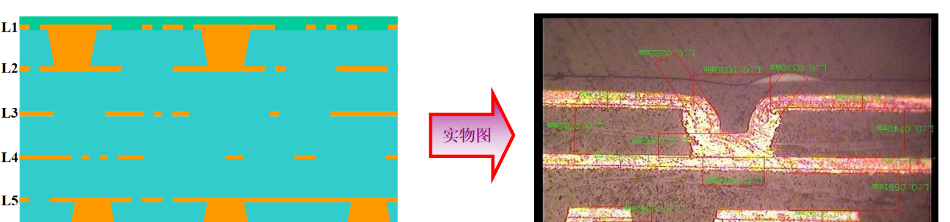
② 一阶HDI板(有埋孔
③ 二阶HDI板(含叠孔、阶梯孔)
④ 二阶HDI板(含叠孔、阶梯孔、孔上垫
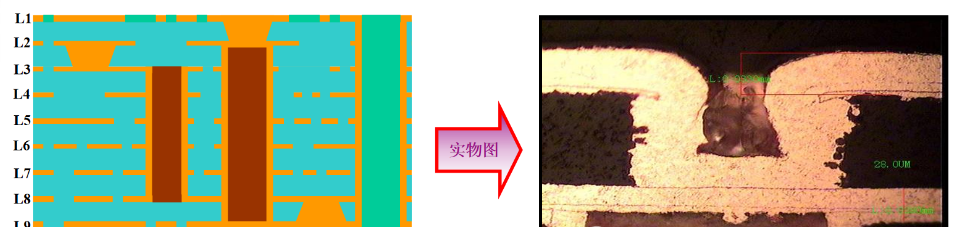
⑤ 三阶HDI板(含叠孔、阶梯孔)
⑥ 任意层互联
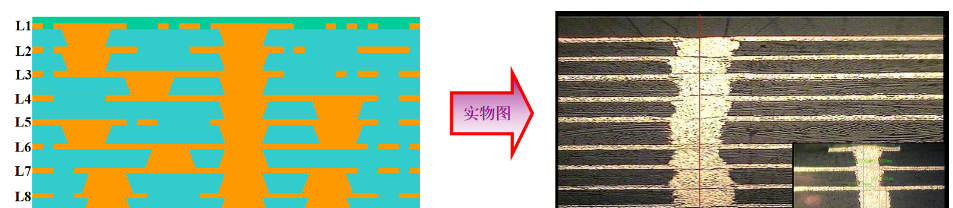
三、实例研究
本文以六层带叠加导通孔无铁芯印制板的工艺为主要讲解,重点介绍盲孔叠孔填孔制造工艺。
示例产品的技术要求:
--设计层数:6层
--芯板厚度:0.1mm(H/H)含铜
--板厚:0.38±0.05mm(成品)
--电镀要求:所有盲埋孔做电镀填孔工艺
--最小线宽/线距设计:2mil/2mil(局部削PAD保证线距)
--盲孔最小ring:设计:2mil
叠孔制作图示
此板盲孔的制作从芯板层开始制作,每层均有盲孔设计,随着层数的增加,盲孔叠孔数量亦随之增加,叠孔制作过程如下图:
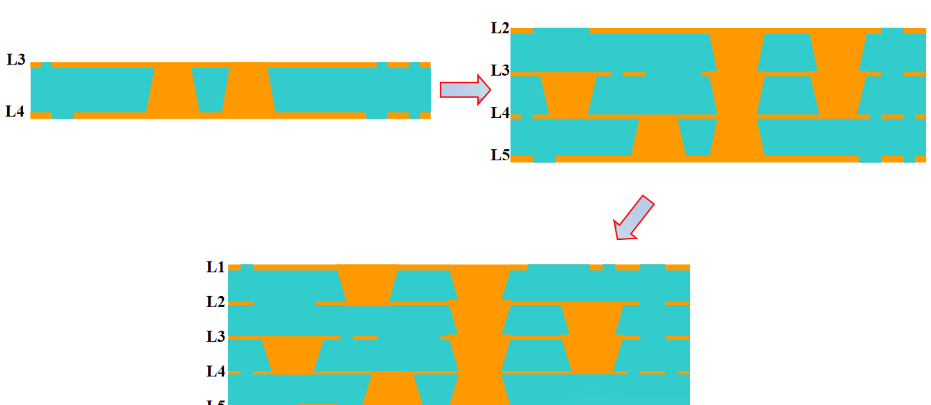
层压结构图示
此板是以L3/4层作为母板,采用减成法进行制作,共进行两次压合,其压合结构如下图:

高密度互连板叠孔制造工艺是一个精细且复杂的过程。首先进行内层线路制作,经开料、图形转移、蚀刻、检测等工序形成内层线路;接着进行层压,通过半固化片粘结内层板;随后钻孔,规划并钻出叠孔,处理孔壁;再进行镀铜,含除胶渣、化学镀铜与电镀铜;之后制作外层线路,经图形转移、蚀刻、检测确保质量;完成后进行阻焊制作与字符印刷,保障线路保护与标识清晰;接着选择合适的表面处理工艺;最后进行外观与电气性能等最终检测,合格后包装,以确保产品符合要求 。

 触摸屏HDI
触摸屏HDI 服务智能机器人线路板
服务智能机器人线路板 服务智能机器人线路板
服务智能机器人线路板 家庭智能机器人线路板
家庭智能机器人线路板