在增层HDI PCB线路的制程中,环氧树脂表面必须蚀刻形成微细的凹凸以便电镀铜可以和环氧树脂表面产生锚定的链结作用,如果凹凸太小时,铜的剥离强度会降低,较低的剥离强度反而有利于蚀刻。图5.21是FR4 HDI PCB电路板18um导体层,线宽为100um的蚀刻横截面。下面为可以看到锚定的凹凸。蚀刻时由于无法将锚定内部的铜完全蚀刻,因此会有部分的铜残留,这些残留的铜是造成铜迁移的主要原因。
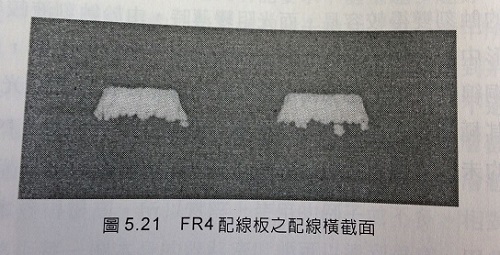
图5.22是增层电路板上100um线宽导线的横截面。导线厚度为23um。其锚定的部分比FR4基板小。由于深入环氧树脂内部的铜较少,因此在蚀刻的时候比较能将铜蚀刻完全。增层电路板的导线如果厚度变薄时,也比较能形成细线宽。
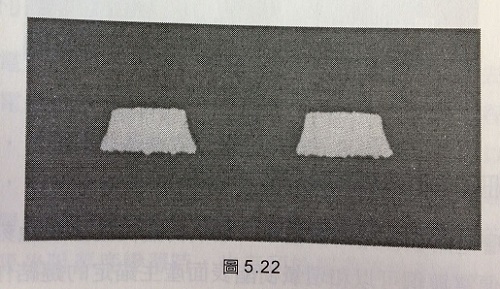

 触摸屏HDI
触摸屏HDI 服务智能机器人线路板
服务智能机器人线路板 服务智能机器人线路板
服务智能机器人线路板 家庭智能机器人线路板
家庭智能机器人线路板