当初号称可以随机架构连结结构的ALIVH技术,由于属于专属的技术产品,至今采用这种技术的厂商固然略有增加。但是就整体的市场面而言,其所需要的专属自动化设备及材料却限制了它的普及性。另外在电子产业中,HDI板组装制程中的重工也是业者必然会面对的问题,但是这类的技术所采用的导电膏材料微孔技术却限制了重工的可行性。
目前部分的业者会面对相关结构的产品,在重工过过程中有相当比例的产品会发生焊垫脱落的问题。当然这方面的问题,目前相关业者也在努力的解决与克服中,但是比起用传统的电镀填孔制作高密度电路板(HDI板),这类导电膏微孔技术又面对了另外一项挑战。而这样的挑战对于相类似的产品而言,只要是利用导电膏制作的微孔电路板(HDI板),也都将面对同样的处境,这当然就包括了B2IT的技术了。
上些手机大厂于近期推出了一些不同的设计想法,尤其是全球手机逐渐走向3G系统的时代,高堆叠密度的电路板需求将逐步成长,因此他们开始要求单边加3的结构设计。为了获得最大的设计弹性,同时能够得到最佳的电性与稳定可靠的重工可能性,因此对电路板业者要求提供有效的解决方案,而全电镀填孔的堆叠结构于此产生。
在网站上就可以搜寻到一些比较典型的制程技术,其中以日本领导厂商lbiden所提出的FVSS(free via stacked up structure)结构与制程比较受到瞩目。其实际的产品断面切片,如图3.34所示。因为电路板的连结完全采用镀铜技术制作,因此可以摒除用导电膏制作所产生的多数缺点,当然比导电膏制作来说,其所增加的钻孔与电镀等成本,就是采用者必需要同时加以考虑的了。
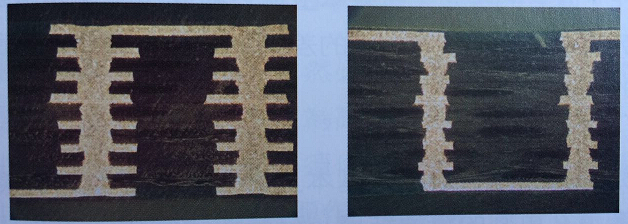
图3.34 FVSS技术所制作的微孔高密度电路板(HDI板)断面
其所展示的基本制程,如图:3.35所示。
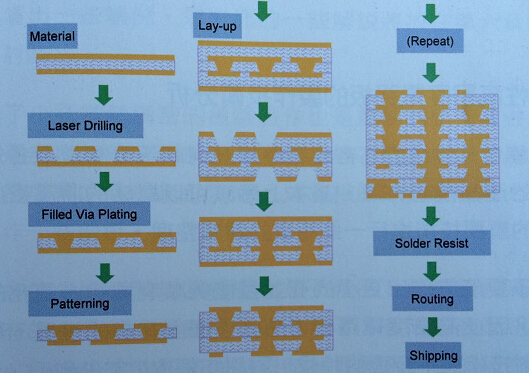
图3.35 FVSS技术的基本制程作法
制程如图中所述,是从薄的双面板开始制作,先进行盲孔钻孔与填孔电镀,接着进行线路制作与压板前的所有准备工作,其它的后续工作基本上与一般高密度电路板(HDI板)采用的序列式成长制程没有太大的差异,只是大量引进了盲孔填孔的技术。
这样的结构与制程,基本上具有的好处是可以制作比导电膏填孔更密的导通结构,另外在导电镀方面也比导电膏要来得好。不过以目前电镀填孔比一般填孔的成本高出许多,以及多数厂商对于填孔技术的熟悉度仍待加强来看,这种技术的快速普及性仍待观察。

 触摸屏HDI
触摸屏HDI 服务智能机器人线路板
服务智能机器人线路板 服务智能机器人线路板
服务智能机器人线路板 家庭智能机器人线路板
家庭智能机器人线路板